成像系统
DSC300 Gen3 投影扫描仪
DSC300 Gen3 是 SUSS 的全自动高吞吐量投影光刻解决方案,适用于 300mm 和 200mm 晶圆上的先进封装。它采用专有扫描技术,集高性能、低成本和高工艺通用性于一身。
成像系统
DSC300 Gen3 是 SUSS 的全自动高吞吐量投影光刻解决方案,适用于 300mm 和 200mm 晶圆上的先进封装。它采用专有扫描技术,集高性能、低成本和高工艺通用性于一身。

专为先进封装应用而设计
DSC300 Gen3 基于先进的 Wynne-Dyson 光学系统,具有成像对准精度高、对准稳健、基板处理灵活等特点。这确保了晶圆级封装、扇出和 2.5D/3D 集成所需的精度、良率和适应性。
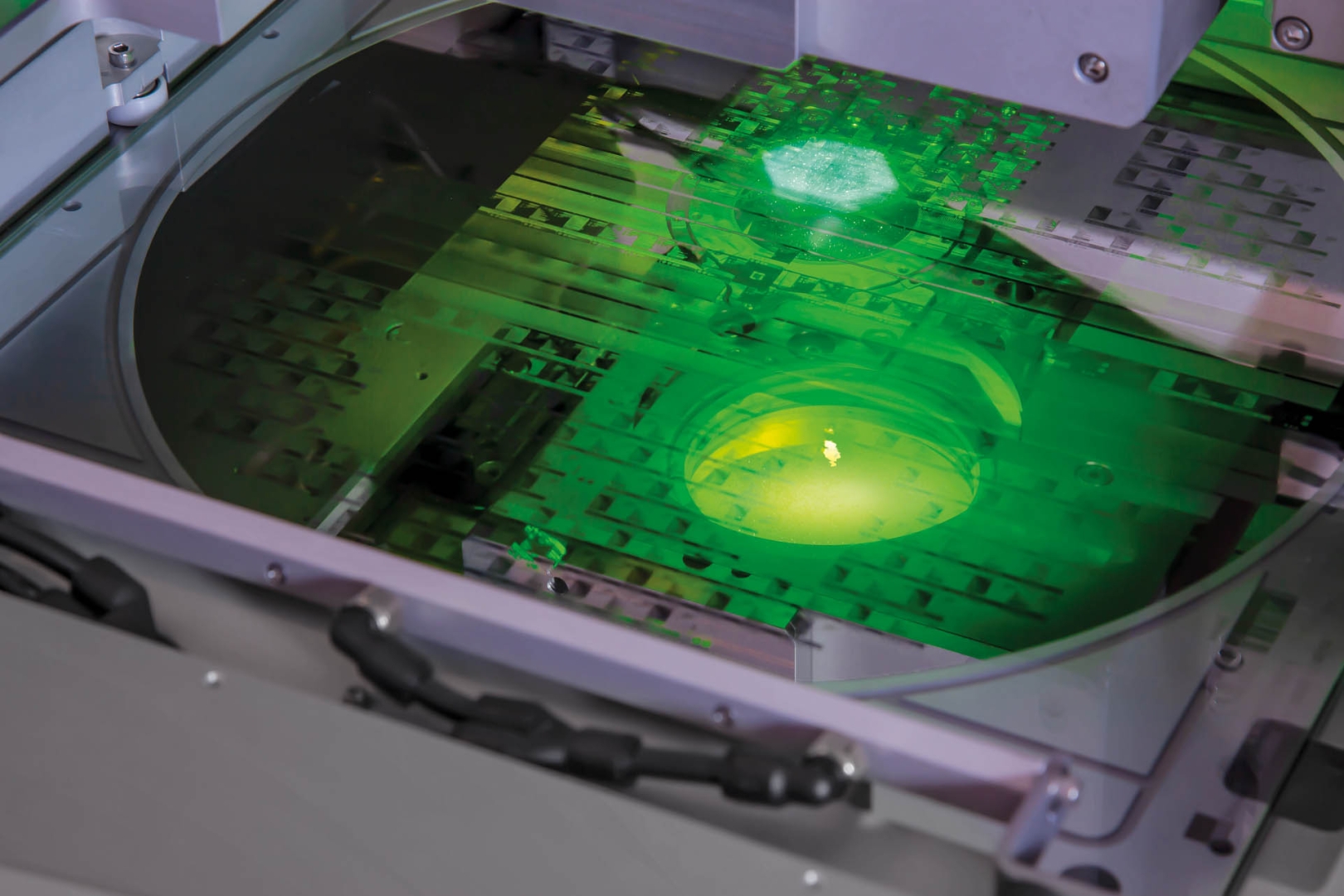
想了解更多详情?请点击下面的链接下载技术数据表和产品介绍,了解更多产品信息。